Phone: 13908216697
Email: tuyadong@mpm-jx.com
光刻掩模版与晶圆高精密测试仪器
2024-07-09 09:22:25
1160
岷山精测
光刻掩模版与晶圆高精密测试仪器
研究基础:突破了亚微米级掩模版缺陷成像技术,实现了100nm表面缺陷检测,突破了缺陷智能检测与快速识别技术、晶圆面形动态高精度测量。
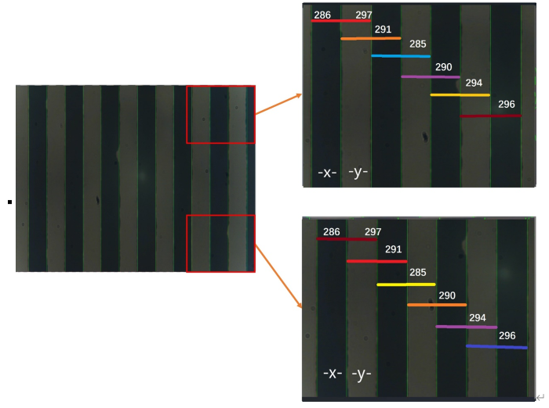
高精密复检Review单元
主要由全视场高清扫描成像系统、高精密复检Review单元、三轴位移平台、图像处理设备等部分组成,40X镜头下像素当量可达0.043μm(43nm)。
成像效果对比:
明场成像对麻点凹坑等类圆型缺陷的成像对比度、锐利度更佳,但对划痕的灵敏度较低,容易造成划痕漏检。
暗场成像对划痕等边缘特征突出的缺陷对比度、灵敏度更高,但对缺陷的强度辐射成像敏感,容易导致缺陷尺寸被错误估计。

明场成像 暗场成像

明场成像 暗场成像
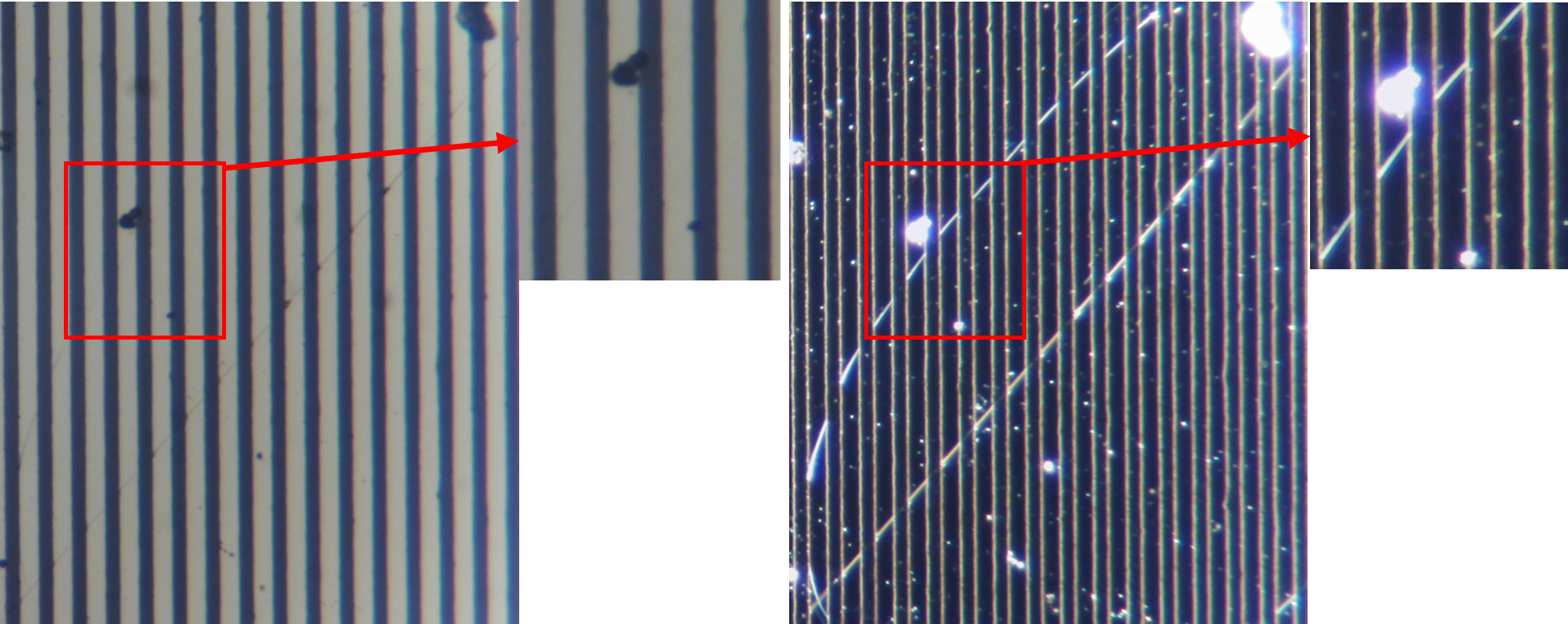
明场成像 暗场成像
以上成像方式各有优缺,在实际运用中需要对缺陷进行能量标定。

缺陷处理软件对于标准3μm光栅尺的检测结果



















